- 博众投资:后摩尔时代,Chiplet或将助力中国半导体破局!
- 2022年08月10日来源:博众投资
提要:本文由博众投资编辑整理。全球半导体蓬勃发展,相关政策大力支持,半导体产业迎来史上最好的时机。随着晶体管电路性能接近极限,先进封装成为集成复杂度最小化、实现成本最优化的突破路径。
本文由博众投资编辑整理。全球半导体蓬勃发展,相关政策大力支持,半导体产业迎来史上最好的时机。随着晶体管电路性能接近极限,先进封装成为集成复杂度最小化、实现成本最优化的突破路径。(博众投资)
作为引领全球电子封装技术的重要会议,ICEPT2022电子封装技术国际会议,将于2022年8月10-13日在大连盛大举办!ICEPT2022将吸引国内外高校、研究机构、电子封装产业相关厂商及来自近20个国家和地区,超过600位知名专家、学者和企业界人士踊跃参与!为先进封装领域学术新进展、应用新技术、创意新理念提供了产学研用深度交流平台。

近期,先进封装概念持续受到市场关注,拜登签署3500亿《芯片和科学法案》,今日A股半导体方向的相关板块纷纷低开,不过开盘后相关个股纷纷快速反弹,其中,Chiplet概念领涨,龙头大港股份7连板,苏州固锝、文一科技等同样涨停;气派科技、易天股份、赛微电子、华正新材等跟随上涨。

Chiplet:延续摩尔定律—先进制程替代之路
Chiplet(芯粒)模式是在摩尔定律趋缓下的半导体工艺发展方向之一。近几十年来,芯片制造工艺基本按摩尔定律发展,单位面积芯片可容纳晶体管数目大约每18个月增加一倍,芯片性能与成本均得到改善。但随着工艺迭代至7nm、5nm、3nm及以下,先进制程的研发成本及难度提升,开发先进制程的经济效益逐渐受到质疑。后摩尔定律时代的主流晶片架构SoC(系统单晶片)推动摩尔定律继续向前发展,将多个负责不同运算任务的元件集成于单一晶片上,用单个晶片实现完整功能,各功能区采用相同制程工艺。Chiplet模式或存在弯道超车机会,该模式将芯片的不同功能分区制作成裸芯片,再通过先进封装的形式以类似搭积木的方式实现组合,通过使用基于异构集成的高级封装技术,使得芯片可以绕过先进制程工艺,通过算力拓展来提高性能同时减少成本、缩短生产周期。总的来说,Chiplet是一种将多种芯片(如I/O、存储器和IP核)在一个封装内组装起来的高性能、成本低、产品上市快的解决方案。
Chiplet方案对封装工艺提出了更高的要求。Chiplet与SiP相似,都是进行不同元件间的整合与封装,而Chiplet的各裸芯片之间是彼此独立的,整合层次更高,不集成于单一晶圆片上,Chiplet目前封装方案主要包括2.5D封装、3D封装、MCM封装等类型。Chiplet的封装方案要实现各裸芯片之间的互联,同时也要保障各部分之间的信号传输质量。 (博众投资)
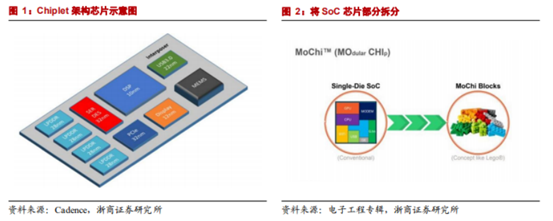
巨头布局:华为/AMD/Apple—产品案例视角
华为:首推7nmChiplet云服务器方案
华为推出基于Chiplet技术的7nm鲲鹏920处理器。华为推出的鲲鹏920是业界领先的ARM-based处理器,根据公司官网消息该处理器采用7nm制造工艺,基于ARM架构授权,由华为公司自主设计完成,通过优化分支预测算法、提升运算单元数量、改进内存子系统架构等一系列微架构设计,大幅提高处理器性能。典型主频下,SPECintBenchmark评分超过930,超出业界标杆25%。同时,能效比优于业界标杆30%。鲲鹏920以更低功耗为数据中心提供更强性能。该处理器创建了相干缓存子系统以将多核集成到单个小芯片中,同时开发了专用并行小型IO块,以实现二维封装解决方案的高带宽芯片间连接。

AMD:联手台积电推出3DChiplet方案
AMD联手台积电推出3DChiplet产品。AMD于2021年6月发布了基于3DChiplet技术的3DV-Cache,该技术使用的是台积电的3DFabric先进封装技术,将包含64MBL3Cache的Chiplet以3D堆叠的形式与处理器进行了封装。2022年3月AMD推出了Milan-X霄龙处理器,该处理器是基于Milan的第三代处理器EPYC7003的升级版本,通过使用AMD的3DV-Cache堆叠技术实现了768MB的L3缓存。Milan-X是一个包含9个小芯片的MCM,其中包括8个CCD裸片和1个大型I/O裸片。(博众投资)

苹果:双M1Max互连缔造高性能方案
苹果推出采用台积电CoWos-S桥接工艺的M1Ultra芯片,实现性能飞跃。苹果2022年3月发布的M1Ultra芯片采用了独特的UltraFusion芯片架构,借助台积电的CoWos-S技术,通过两枚M1Max晶粒的内部互连,实现了性能的飞跃。M1Ultra在新架构下,晶体管数量达到了M1的7倍多,同时两颗Max之间的互连频宽可达2.5TB/s。M1Ultra内部集成内存128GB,包含8个16层堆叠的HBM(高带宽内存)堆栈的内存部件,核心传输速率达3200M,实际传输带宽超过800GB/s。这款产品实现了Apple芯片与Mac系列电脑的又一次重大飞跃,具有里程碑意义。
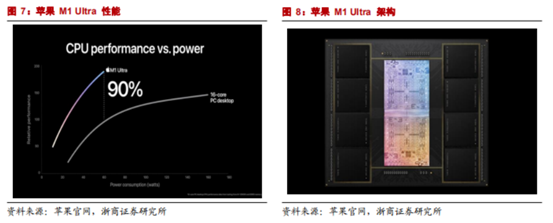
产业革新:先进封装+IP复用—供应链之关键
Chiplet目前封装方案主要包括2.5D封装、3D封装、MCM封装等类型。2.5D封装将多个芯片并列排在中介层(Interposer)上,经由微凸块(MicroBump)连结,让内部金属线连接芯片间的电子讯号,再通过矽穿孔(TSV)来连结下方的金属凸块(SolderBump),再通过导线载板连结外部金属球,实现各部件之间紧密的连接。3D封装则直接将各芯片进行堆叠,在芯片制作电晶体(CMOS)结构,并直接使用矽穿孔来连结芯片间的电子讯号。MCM技术是将多个LSI/VLSI/ASIC裸芯片和其它元器件组装在同一块多层互连基板上,然后进行封装。
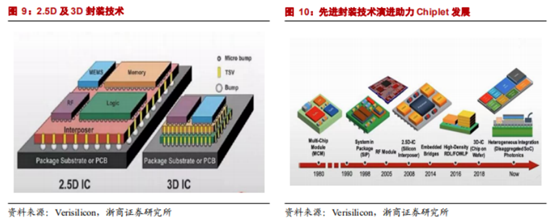
受益方向:聚焦封装/设备/IP环节与供应链变革
先进封装:国内目前在先进制程技术上与国际厂商存在明显差距,Chiplet方案为国内芯片制造业提供了弯道超车机会。国内芯片厂商可以通过采用Chiplet方案来弥补国内先进制程产业链落后的劣势,通过先进封装来提升芯片性能。
IP公司:Chiplet方案降低了芯片设计的成本与门槛,IP复用提高了设计的灵活性。后续IP公司有望实现从IP供应商向Chiplet供应商的身份转变,增加在产业链中提供的价值。
封测设备:Chiplet方案的落地的关键便在于先进封装技术的实现,这对封装设备提高了要求及需求。如Chiplet方案设计大量裸芯片,封测过程需要对大量芯片进行测试以保证最后芯片成品良率。
封装载板:Chiplet方案会采用2.5D封装、3D封装、MCM封装等形式对芯片进行先进封装,这种封装方式会增加ABF、PCB载板层数,具体层数与技术指标要求取决于芯片的设计方案。国内ABF、PCB载板厂商有望受益Chiplet方案的发展。(博众投资)
参考资料:
《半导体行业深度报告:CHIPLET:延续摩尔定律—先进制程替代之路!》浙商证券;2022-08-07;
《半导体行业跟踪报告之五:Chiplet:延续摩尔定律的新技术,芯片测试与先进封装有望获益》光大证券;2022-08-08;
《机械:先进封装工艺与设备研究-先进封装大势所趋,国产设备空间广阔》中泰证券;2022-08-08;
温馨提示
本文观点由--蔡永嘉(执业编号A0600622020001)编辑整理,不构成投资建议,操作风险自负。股市有风险,投资需谨慎!






